中国科大刘世勇教授团队 Angew:基于精准高分子化学的单组分极紫外光刻胶
2024-09-29 来源:高分子科技
在过去几十年中,光刻技术不断进步,以实现更小的临界尺寸,推动集成电路向更高水平的集成发展。极紫外(EUV)光刻已成为制造亚10 nm特征的最先进技术,但其材料面临重大挑战。尽管化学放大光刻胶和聚甲基丙烯酸甲酯是EUV光刻的主要材料,但它们的性能未能达到预期标准。在同时实现分辨率、线边粗糙度(LER)和灵敏度需求的光刻胶开发上,仍然存在显著挑战。
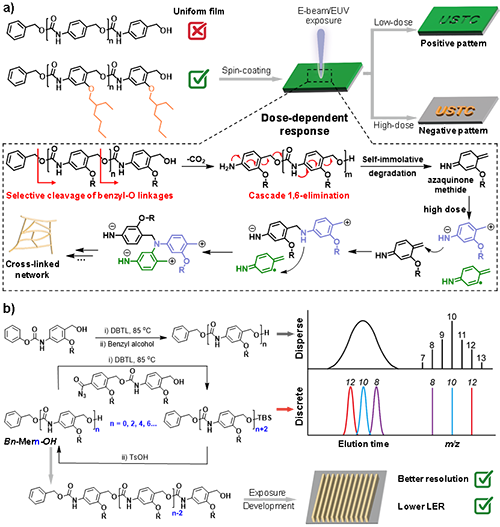
图1. (a) 自降解聚合物在电子束或极紫外光刻中的降解和交联机制。(b) 通过迭代增长法合成的自降解聚合物光刻胶显示出更高分辨率和更低的线边缘粗糙度。
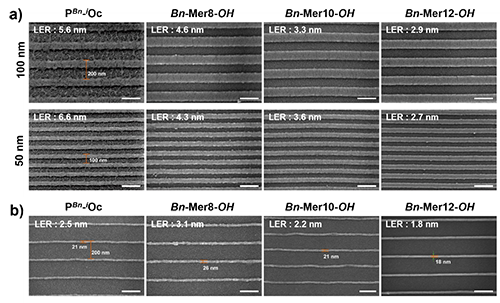
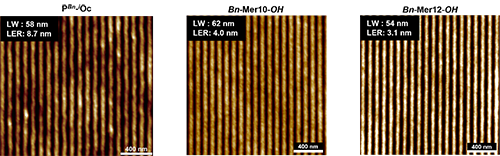

图4. 刻蚀抗性评估
原文链接:https://onlinelibrary.wiley.com/doi/10.1002/anie.202415588
版权与免责声明:中国聚合物网原创文章。刊物或媒体如需转载,请联系邮箱:info@polymer.cn,并请注明出处。
(责任编辑:xu)
相关新闻
- 中南林大/武大/北大联合 Nat. Commun.:多级晶体重构纳米结构集成策略制备高性能辐射制冷生物质复合材料 2026-05-04
- 东华大学武培怡/吴慧青团队 Angew:高性能离子选择膜的开发及渗透能的高效捕获与转化 2026-04-29
- 上海理工岳兵兵、复旦大学朱亮亮等 Matter:光聚集介导相工程助力高性能聚合物半导体与全彩OLEDs 2026-03-28
- 浙大伍广朋、杭师大邱化玉 ACS Nano:兼具高稳定性和高灵敏度的极紫外和电子束倍半硅氧烷光刻胶 2025-10-31
- 清华大学许华平教授 Sci. Adv.:聚碲氧烷 - 一种理想的极紫外(EUV)光刻胶 2025-07-21
- 浙大伍广朋教授课题组 Angew:可水显影的高性能二氧化碳基化学放大光刻胶 2024-09-27
