随着芯片小型化进程的飞速发展,开发高性能光刻胶已经成为半导体芯片制造领域的重中之重。化学放大光刻胶是目前集成电路制造应用最广泛的光刻胶材料,通过构建光酸催化的酸解反应,光刻胶的灵敏度可以实现数量级的提升,弥补了光刻机光源功率下降引发的效率问题。碳酸酯基团和缩醛基团具有较低的酸解活化能,是传统化学放大光刻胶中重要的酸敏感性结构,但由于其过低的活化能,此类光刻胶在放置过程中易产生暗反应,影响储存和光刻稳定性,并且在光刻过程中易发生自显影现象,产生的挥发性物质将污染光刻机镜头。此外,传统化学放大光刻胶使用神经毒素四甲基氢氧化铵作为显影液,这给从业人员的身体健康带来了严重的威胁。在2004年至2009年的五年间,台湾曾报道涉及12名工人的9起不同程度的四甲基氢氧化铵暴露事件,其中三人不幸身亡。因此,如何兼顾光刻胶的灵敏度、稳定性和分辨率,并最大限度地减少光刻过程中对光刻机镜头的污染以及有毒试剂的使用,已经成为光刻胶研发的共性主题。

图1 可水显影的高性能二氧化碳基化学放大光刻胶:合成路线、化学结构、光刻机理和光刻结果

图2 PgCXC的合成方法及其热稳定性表征

图3 P2MeCXC聚合物在酸性条件下的水解研究
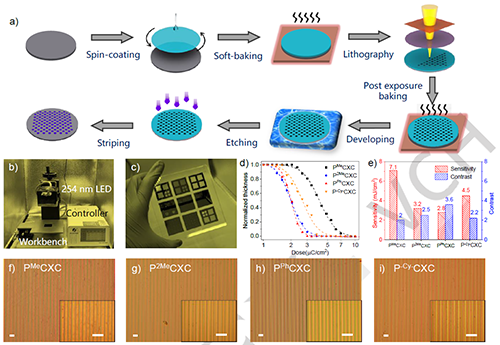

图5 具有不同取代基的PgCXC聚合物的水接触角数据
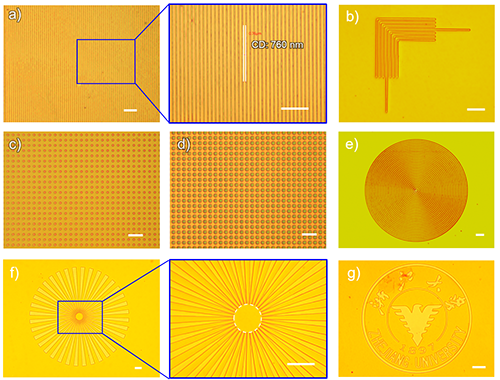
图6 优化后的PPhCXC化学放大光刻胶在254 nm曝光条件下的光刻图案

图7 PPhCXC化学放大光刻胶与商业化深紫外光刻胶性能对比
最后,为了突显PPhCXC化学放大光刻胶优异的光刻性能,作者将其与商用KrF光刻胶HTK1062和ArF光刻胶PBMA进行了性能对比。结果表明,相比于商用深紫外光刻胶PPhCXC化学放大光刻胶表现出了更为优异的灵敏度、对比度、分辨率性能,抗刻蚀性高于PBMA光刻胶38%,在线边缘粗糙度上略弱于HTK1062光刻胶,展现了优秀的深/极紫外光刻和纳米制造领域应用潜力(图7)。
总之,该工作设计合成了一类可水显影的深紫外化学放大光刻胶成膜树脂,探明了该体系的光刻机理,实现了优异的光刻性能,为开发高性能的深紫外和极紫外光刻胶提供了一种新思路。
陆新宇、张瑞生为论文的共同第一作者,杨贯文、李强、李博参与了这一研究工作,伍广朋教授为论文的通讯作者。该研究得到了国家自然科学基金、浙江省自然科学基金和中国博士后科学基金的支持(这个基金支持需要老师修改)。
原文链接:https://onlinelibrary.wiley.com/doi/10.1002/anie.202401850
- 东华大学/苏州大学严锋教授团队 Angew:离子液体与CO2自聚合成聚碳酸酯 2026-05-14
- 杭师大李博、浙大伍广朋 Macromolecules:有机硼咪唑鎓催化剂工程实现二氧化碳高分子资源化利用 2026-04-08
- 河工大刘宾元教授 Macromolecules:环酸酐栓接有机硼路易斯酸碱对 - 打造耐稀释的高效有机硼催化剂用于CO2和环氧丙烷共聚 2026-02-26
- 华科大朱明强教授联合湖北九峰山实验室柳俊教授/向诗力博士团队 CEJ:二元协同增强型化学放大胶助力半导体光刻制造 2024-02-22
- 浙大伍广朋、杭师大邱化玉 ACS Nano:兼具高稳定性和高灵敏度的极紫外和电子束倍半硅氧烷光刻胶 2025-10-31
- 清华大学许华平教授 Sci. Adv.:聚碲氧烷 - 一种理想的极紫外(EUV)光刻胶 2025-07-21
- 中国科大刘世勇教授团队 Angew:基于精准高分子化学的单组分极紫外光刻胶 2024-09-29
